化金板上锡不良改善报告(2011-12-23)

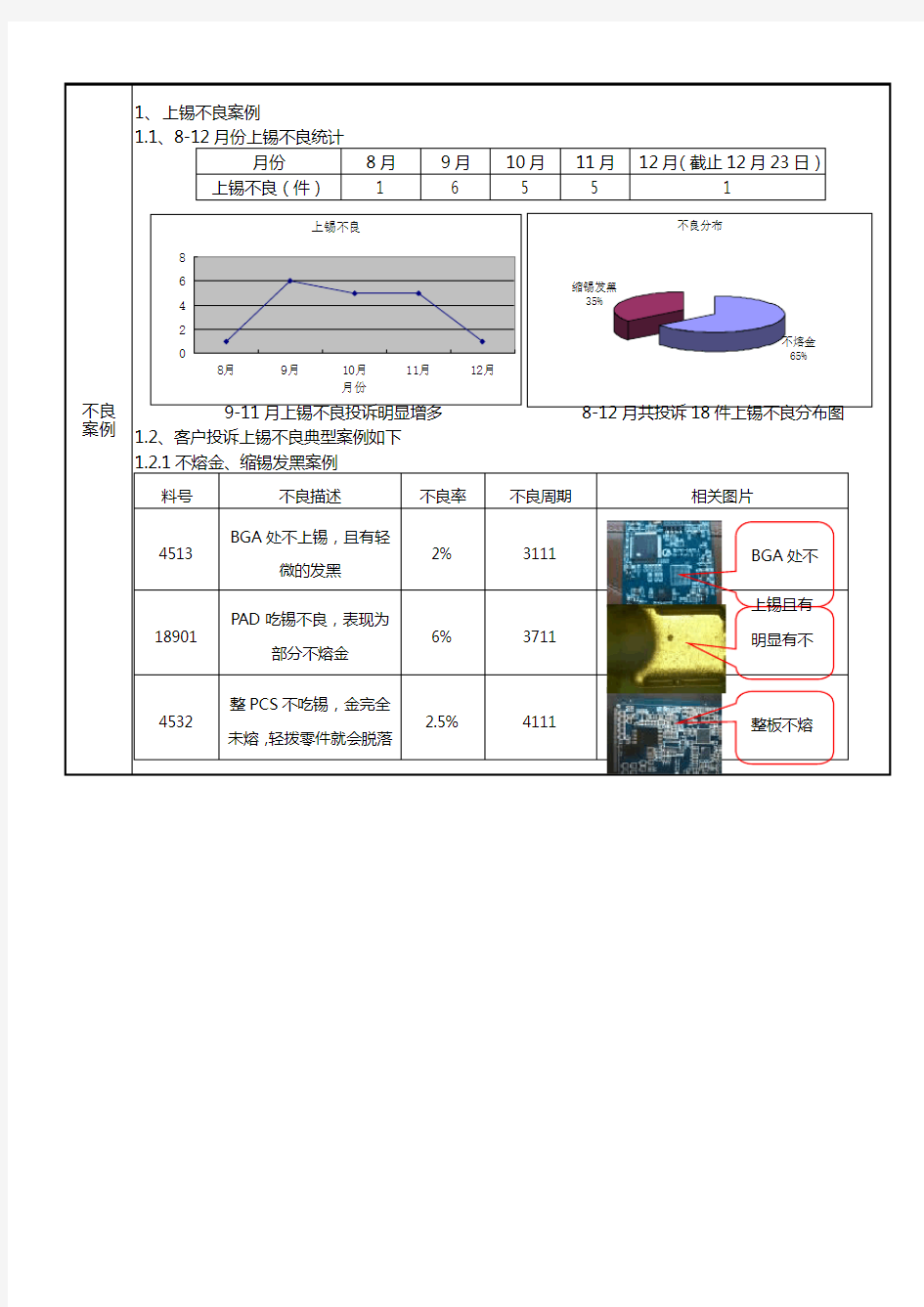
技术报告
文件编号:
收件 生产、品管、客服、副总办
制作 2011/12/23 抄送 王主管、叶经理、杨经理、席经理、刘副总 审核 FAX
批准
事件 主题: 化金板上锡不良跟进改善报告
责任对象 加工
现状
描述 从9月份开始客户端抱怨化金板上锡不良频繁,9-11三个月均有上锡不良投诉5-6起,现我部根据客户端提供实物板进行相应的测试分析,结合深昊的改善意见,提出了一系列改善措施并要求生产严格执行,
待跟进改善后化金板在客户端上线品质状况,从12月份客户投诉状况来看,上锡不良已有明显改善。
不良 案例
1、 上锡不良案例
1.1、8-12月份上锡不良统计
月份 8月 9月 10月 11月 12月(截止12月23日)
上锡不良(件)
1
6
5
5
1
9-11月上锡不良投诉明显增多 8-12月共投诉18件上锡不良分布图 1.2、客户投诉上锡不良典型案例如下
1.2.1不熔金、缩锡发黑案例
料号
不良描述
不良率
不良周期
相关图片
4513
BGA 处不上锡,且有轻微
的发黑
2%
3111
18901
PAD 吃锡不良,表现为部
分不熔金
6%
3711
4532
整PCS 不吃锡,金完全未
熔,轻拨零件就会脱落
2.5%
4111
上
24688月
9月
10月11月
12月
月
件数不
不65%
缩35%
BGA 处不上锡且有发黑 明显有不熔金 整板不熔金且掉件
不良案例1.2.2案例分析
料号BGA处EDS图片EDS光谱图给客户端结论
4513 外界污染
18901 金面轻微污染
4532
金层有阻焊层,可
能有菌类污染
1.2.3小结
从上述三个案例分析来看,不熔金、缩锡发黑应为焊接过程中润湿性不够,导致无法熔掉金层或无法形成IMC层,继而产生上锡不良;影响润湿性原因很多,PCB表面污染、镍层腐蚀氧化等都会影响影响润湿效果,客户端炉温低、锡膏助焊剂差等也会影响润湿性。
上锡不良模拟分析2、原因分析(鱼骨图)
上
锡
不
良锡膏退洗
作业不规范
辅助工具不良
培训不到位
PCB不良
参数不当
保养不到位
酸碱恶劣环境
人
物
环
机
法
锡膏异常客户炉温异常
问题调查3、原因分析:
3.1.PCB不良原因
3.1.1.从化金→包装所有工序操作时未佩戴干净手套或工作台面不洁都会使金面带来污染;
3.1.2.我司金板基本为先化金后文字,文字不良会有一定比例的退洗,如若有退洗不净,残留文字油就会
变成污染源;
3.1.3.化金线保养不到位
3.1.3.1.镍缸及金缸后水洗未按要求更换保养导致水质很差(现场检查时缸壁滑手),水洗又为酸性,酸性
环境下极易产生菌类,菌类可能会附着金面成为污染物;
3.1.3.2.化金后处理酸洗及其后两水洗日常保养时未用扫把对缸壁进行彻底清洁,缸壁有滑手污垢,后处
理滚轮未按要求频率用酒精浸泡清洗,不但板面清洗不净可能会给板面带来新的污染;
3.1.
4.金槽金浓度偏低、镍层磷含量偏低、草酸残留等都会对镍层造成攻击,镍层腐蚀严重或氧化时会形
成脆弱的IMC层或无法形成IMC层。
3.2.客户端存在问题点
3.2.1.客户端印锡膏时存在漏印锡膏情况(261跟线时发现由于印制锡膏后无专人检验或AOI导致一定比
例漏出贴片),漏印锡膏肯定会照成上锡不良;
3.2.2.客户端印制锡膏后放臵过久、印制锡膏退洗不良等情况都会导致上锡不良;
3.2.3.客户端炉温不稳定、reflow未充氮气等都会造成上锡不良。
调查跟踪4.不良问题跟踪
4.1.上文提到的3.1.1及3.1.2在之前的上锡不良改善方案中早有要求,各部门必须严格按章操作。
4.2化金线保养不到位,并不是化金未做保养,而是在酸碱泡或换槽时未用扫把或碎布彻底清洗槽壁污垢,
还有部分水洗未按要求更换,可能让缸壁滋生菌类有“可趁之机”。
4.2.1.前处理酸洗槽大保养后及用扫把及碎布彻底清洁后对比
4-1酸碱泡后缸壁仍有污垢 4-2用扫把彻底清洁后
4.2.2.金回收后水洗槽缸壁大保养后及用扫把及碎布彻底清洁后对比
4-3酸碱泡后缸壁有白色污垢 4-4用扫把彻底清洗后
明显有污垢污垢已被
清理
白色污垢用扫把清洗多次才能
清洗干净,此污垢可
能为菌类
调查跟踪4.2.3.后处理酸洗槽大保养后及用扫把及碎布彻底清洁后对比
4-5酸碱泡后缸壁仍有污垢 4-6用扫把彻底清洗后
4.3金槽浓度偏低会加大对镍层的攻击(金槽金浓度偏低、镍层磷含量偏低、草酸残留等相关模拟实验在
下文试验跟进中会有详细体现)
4.3.1.8月2日-12月13日金槽金浓度化验结果具体如下:
总化验次数≤400PPM次数400-500PPM次数500PPM以上次数最低化验值不合格率30次3次11次19次250PPM 36.7%
4.3.2.从上表可以看出8月2日-12月13日金缸化验不合格率高达36.7%,且最低化验值仅250PPM,金槽
浓度极不稳定,给镍层带来更大腐蚀风险。
4.4.客户端问题点
4.4.1.我部与客诉人员一同到261客户端SMT现场跟进发现,100PCS中有2PCS BGA处漏印锡膏,4PCS需
退洗锡膏,且2PCS漏印锡膏之板是我部在贴片前轨道上发现(也就是漏出),而客户端正是投诉BGA 处上锡不良(虚焊)。
4.4.2. 客户端印制锡膏后放臵过久、印制锡膏退洗不良等导致上锡不良情形在下文实验跟进会有详细体
现;另客户端炉温不稳定、reflow未充氮气等都会造成上锡不良,会与PCB不良导致上锡不良情形类似,待客户端纠正错误后将问题推给PCB,我们将无从查证。
试验跟进5.镍层腐蚀及上锡不良相关实验
5.1.金缸不同金浓度对镍层腐蚀情形
5.1.1.分别在补加金盐前、补加金盐后及补加金盐后生产200m2时做1SET沉镍金实验板,然后外发进
行SEM分析;
5.1.2.试验结果具体如下:
类别
项目
补加金盐前补加金盐后生产200m2补加200g金盐后金浓度439PPM 569PPM 690PPM
SEM图片
镍层腐蚀情况严重轻微较轻微
5.1.3.从以上实验结果可知,金缸金浓度越低,沉金时对镍层的攻击越大,镍层腐蚀也会越严重。5.2镍缸不同MTO值生产时镍层P含量及耐腐蚀情况
5.2.1.分别在镍缸不同周期时做1SET实验板,然后外发到深昊进行EDS&SEM分析;另要求深
昊加工线也做同样实验分析,与我司实验结果对比;
明显有异物
污垢已被
清理
试验跟进5.2.2.实验结果具体如下:
5.2.2.1.我司实验板分析结果
MTO值
项目
0MTO 0.5 MTO 1.0 MTO 1.5 MTO 2.2 MTO SEM图片
镍层P含量7.82% 6.76% 7.44% 8.71% 8.82%
5.2.2.2.深昊加工线实验板分析结果
MTO值
项目
0MTO 0.5 MTO 1.0 MTO 1.5 MTO 2.0 MTO SEM图片
镍层P含量 6.95% 7.99% 7.55% 8.65% 8.56%
5.2.3.通过以上实验验证,磷含量越高耐腐蚀性越好,镍缸0-1MTO磷含量会相对较低,1MTO
之后磷含量会逐步升高。
5.3.化金线不同微蚀量对镍层晶格及耐腐蚀性影响
5.3.1.选取4SET报废板以相同条件过前处理后,分别以5、10、20、40S微蚀走化金线沉镍
金,然后将实验板外发SEM分析;
5.3.2.实验结果具体如下:
微蚀时间
项目
5秒10秒20秒40秒SEM图片
微蚀量11.2U〞24.5 U〞43.7 U〞74.8 U〞
5.3.3.从以上分析结果可知,微蚀时间在10S及20S时镍层晶格细腻且腐蚀较轻微,微蚀时
间在5S及40S时镍层晶格较大且腐蚀相对严重;且10S微蚀镍层腐蚀最轻微,5S微蚀镍层腐蚀最严重。
5.4草酸及金面清洁剂残留腐蚀试验
5.4.1.取6SET报废板正常化镍金后,3SET化金后处理清洗时酸洗配成草酸,另3SET化金后
处理清洗时酸洗配成金面清洁剂,然后分别包装后放臵一周、半个月、一个月外发进行SEM分析;
5.4.2.实验结果具体如
时间
类别
一周半个月一个月
草酸残留SEM
试验跟进
时间
类别
一周半个月一个月
金面清洁剂残留
SEM
5.4.3.从以上实验结果可以看出,草酸及金面清洁剂都会对镍层形成残留腐蚀,且随着时间延长腐蚀会加
剧,另金面清洁剂的残留腐蚀明显比草酸要轻微。
5.5.新开缸通过提高次磷酸钠浓度提高磷含量
5.5.1.分别用120L M及120L M+7L B两种开缸方式试做2SET实验板,外发进行EDS&SEM分析;
5.5.2.分析结果具体如下:
开缸方式
类别
120L M开缸120L M+7L B开缸
镍层SEM
镍层P含量7.82% 8.06%
Na2HPO223g/l 28 g/l
5.5.3.通过以上结果对比可知,提高开缸时Na2HPO2浓度可以略微提高镍层磷含量,从SEM图也再次验证
磷含量越高耐腐蚀性越好。
5.6.客户端验证试验
5.6.1.取客户端投诉23601氧化严重报废之板30SET到客户端印锡膏直接过炉,炉后有1SET轻微不熔金;
5.6.2.做13PCS 19596(表面处理做成化金)实验板,其中1PCS印锡膏后立即过炉,剩余12PCS印锡膏
后,6PCS立即退洗,且故意在焊点上残留少许锡膏,然后同未退洗6PCS一起放臵4H,4H后将退洗6PCS重新印锡膏后同未退洗6PCS一起过回流焊;
5.6.2.1.试验结果显示,印锡膏后直接过炉1PCS上锡OK,未退洗之板有1PCS单点不熔金(见图5-1),退
洗之板有1PCS中1个焊点脱落(见图5-2)。
图5-1 图5-2
5.7.小结
5.7.1.金缸金浓度偏低会增加对镍层镍层攻击,继而会使镍层腐蚀更严重;
5.7.2.不同MTO值时生产之板P含量不同,刚开缸时镍缸沉积速率很快但P含量较低,耐腐蚀性较差,随
着MTO值的增加,镍层P含量也会提高,故我们需通过调整新镍缸活性及开缸方法保证0-1MTO镍层P含量在7%以上,增强镍层的抗腐蚀能力;
明显有
金未熔
有一焊
点脱落
试验跟进5.7.3.化金线上不同微蚀量对镍层晶格大小会有影响,微蚀时间过短或过长都不利于镍层的耐腐蚀性,我
司10S微蚀时间为最佳;
5.7.4.草酸比金面清洁剂残留腐蚀严重,故我司应将化金后处理酸洗槽配成金面清洁剂;
5.7.5将镍槽NaH
2
PO
2
建浴浓度提至上限,可以适当提高0-1MTO时镍层P含量,适当降低刚开缸时沉积速率(7-8U〞/min为最佳),可以将0-1MTO时镍层P含量控制在7%以上;
5.7.6客户端像漏印锡膏等问题点肯定会导致上锡不良,锡膏退洗不净、印制锡膏后放臵过久等都会有导
致上锡不良可能,故客户端自身存在的问题需我司售后人员现场跟进并及时指正,与客户端做好沟通要求彻底改善客户端自身问题点。
结论6.1.通过对近段出现上锡不良综合分析,以及大量的验证实验得知,我司金含量、镍层磷含量、微蚀量等
控制不佳,致使镍层腐蚀加重,锡镍之间无法形成IMC层或形成脆弱的IMC层导致上锡不良;
6.2.镍缸及金缸后水洗未保养到位且为酸性环境极易滋生菌类,在加上后处理保养未做彻底(缸壁滑手、
烘干段滚轮未按要求清洁等),板面极易清洗不净或残留异物,到客户端上线时也就变成了阻焊层;
6.3.我司金板之前一直都使用草酸清洗(且为多次),而实验得知酸性较强(与金面清洁剂对比)的草酸会
对镍面形成一定的残留腐蚀,而且随着时间的增加而加重,腐蚀到一定程度也会致使锡镍之间无法形成IMC层或形成脆弱的IMC层导致上锡不良;
6.4.我司及客户端生产过程中违规作业(未佩戴手套、工作台面不洁等)都可能会导致上锡不良。
改善行动7.1.化金线各水洗槽一定要按要求更换及保养、特别是镍缸及金缸后水洗,更换后一定要用扫把或碎
布对槽壁进行彻底清洁;(生产执行、品管、工艺监督)
7.2.化金后处理清洗烘干大PNL板(选化板除外)时不允许开酸洗,只有成检清洗小板才开酸洗;后
处理草酸配成金面清洁剂且按1次/天频率更换;(生产、成检执行、品管工艺监督)
7.3.化金后处理保养按每半个月大保养一次,烘干段滚轮一个月至少进行一次酒精浸泡清洗,酸洗槽
及其后两水洗保养后必须用扫把或碎布彻底清洁缸壁;(生产执行、品管工艺监督)
7.4.镍槽开缸时多加7L B剂,新开缸0-1MTO沉积速率不能超过9U〞/min,按7-8 U〞/min速率来调
整镍厚,即若镍缸时间为1200S,则镍厚最好控制在140-160 U〞为最佳,1MTO之后按6-8U〞/min 控制即可;(生产、品管执行、工艺监督)
7.5.金缸金含量按500PPM以上管控,生产要及时补加金盐,金缸浸金时间也要尽可能缩短,保证达到金厚
即可;(生产执行、品管、工艺监督)
7.6.金回收要求7天更换一次,生产严格执行;(生产执行、品管工艺监督)
7.7.化金线微蚀时间无特殊情况设定为10S,如需调整要经过工艺允许才可在10-30S范围内调整;(生产、
工艺执行、品管监督)
7.8.化金后处理不允许清洗铜板(成检、样品等),化金需做清洗记录,严防清洗铜板导致水洗过脏;(生
产、成检、样品执行、品管、工艺监督)
7.9.化金板从化金→包装所有部门必须配戴干净手套、做好台面清洁及相关设备的保养;(化金及后制程执
行、品管、工艺执行并做监督)
7.10.至于客户端的不良问题点需客服与客户做好沟通,尽可能规范操作。(客服执行)
備注
皮肤压疮不良事件高质量持续改进案例分析报告范文
2012年4月份护理安全(不良)事件分析 (一)事件简要经过 患者陈述初,男,72岁,住院号376019,因胆囊坏疽、感染性休克、MODS 于4月20日由外院转入ICU治疗,入院时神志模糊,双下肢及背部皮肤呈花斑样改变,全身皮肤黄染,脑梗后右侧肢体活动障碍,入院后予以呼吸机辅助呼吸,抗休克等治疗。4月21日4:55急诊胆探术后气管插管带呼吸机回ICU,经一系列生命支持治疗后4月25日脱机拔管,4月28日22:00发现臀裂靠左侧5cm处有1.5×1cm大小水泡,立即予以水胶体敷料保护下抽取水泡等处理,5月1日患者出院,与家属沟通并告知出院后更换水胶体敷料等护理方法,家属表示理解无异议。 (二)制定计划 1.原因分析 1、责任护士对压疮风险防范意识不强,交接班制度落实不到位; 2、该患者高危评分29分,责任护士未引起高度重视,未立即上报难免压疮,并采取有力的预防措施; 3、责任护士对患者的动态评估不仔细; 4、护士长、高级责任护士督导不到位。 2.整改措施 1、认真落实交接班内容; 2、强化责任护士责任心及对压疮高危患者发生压疮的风险意识,及时采取有效的预防措施尽量避免发生压疮; 3、每班进行压疮高危评分,及时评估和申报难免压疮; 4、科内培训压疮预防和治疗的方法,尤其是0.9%生理盐水清洗机更换水胶体敷料时0度撕降的方法; 5、护士长、高级责任护士加强督察指导。 (三)具体执行
1、组织全科护士进行核心制度的强化学习,考核通过率100%;加强责任护士工作责任心,与绩效考核挂钩。 2、认真落实交接班内容,制定ICU床旁交接班流程。 3、对危重患者及时评分上报压疮高危评估表,登记科室压疮及压疮高危管理登记本,并采取积极有效的预防措施:及时有效翻身、保持皮肤清洁干燥、睡气垫床、压疮高危部位垫凝胶垫等等。 4、制定ICU病人翻身时间段,高级责任护士组织当班人员团结协作,减轻单一责任护士的工作强度,逐一为患者有效翻身。 5、上报压疮高危患者,每班进行压疮高危评分,登记在护理记录单上,及时评估参照以往评分结果,动态观察皮肤的变化,必要时申报难免压疮,完善压疮高危上报程序和压疮上报程序。 6、科内培训压疮预防和治疗的方法,正确使用压疮防护用具和材料。 7、高责任护士对患者发生压疮的风险防范意识,提升评判性思维。 8、每班的高级责任护士要加强高危患者的督查指导,严格交接班。 9、护士长每天深入病房,掌握病房高危患者的动态变化,及时给与指导意见,并有督查记录。 10、已上报压疮高危患者,转出ICU,当班主班及时评估患者皮肤情况,向科护理部报告病人的转归情况,有备护理部进一步动态了解患者的情况。 11、既往成立了压疮管理小组,具体没有有效落实到位,护士长组织压疮管理小组开会,讨论并制定了ICU压疮管理小组职责。 (四)检查评价 经过近一个月来的压疮高危防范措施的具体执行,落实了岗位职责和核心制度;实行ICU床旁交接班流程,细化了交接班程序,对于压疮的防范意识增强,责任护士的工作责任心大大加强,主动服务意识增强,团队协作能力凝聚,无压疮等护理不良事件发生。对于危重病人皮肤破损的高危因素,大小便潮湿的刺激,不能得到有效的解决。 (五)持续改进 危重症患者大小便失禁,刺激肛周及会阴部皮肤,引起臀部下面潮湿、不
上锡不良原因分析报告
6A7A45001A上锡不良原因分析报告 背景: 2014年5月31日,型号6A7A45001A上锡不良,针对此问题协同徐春梅小姐,前往SMT加工厂分析不良原因。 目的: 为解决问题板的处理方式以及问题板的产生原因,防止再发。 目录: A、试验条件/流程: B、检验分析; C、现场排查; D、总结与建议。 A、试验条件: a.现场温湿度:NA; b.锡膏类别:同方A-P6337-D-900(Alloy:Sn63/Pb37)有铅; c.FUX PCB:E400163A2(无铅喷锡板); d.回流焊峰值:260℃/实际板面温度251℃; e.钢网厚度:0.12mm; f.丝印锡膏厚度:NA; g.丝印方式:手印/机印; B、检验分析: 依试验流程共试验4set E400163A2空板PCB结果如下: b-a、目检1set明显不上锡,相对不良比例25%; b-b、放大镜检验4set 焊盘周边严重锡珠,相对不良比例100%(图组1-1)。 图组1-1 试验方案2共试验5set已贴S/S面PCBA,试验结果如下: b-c目检5set未发现明显不良,相对不良比例0%。 分析:b-b图示锡珠形成机理: 回流焊中出现的锡珠(或称焊料球),常常藏与矩形片式元件两端之间的侧面或细间距引脚之间。在元件贴状过程中,焊膏被置于片式元件的引脚与焊盘之间,随着印制板穿过回流焊炉,焊膏熔化变成液体,如果与焊盘和器件引脚等润湿不良,液态焊料颗粒不能聚合成一个焊点。部分液态焊料会从焊缝流出,形成锡珠。因此,焊料与焊盘和器件引脚的润湿性差是导致锡珠形成的根本原因。 造成焊料润湿性差的原因: 1、回流温度曲线设置不当; 求证:加工厂回流焊温度曲线图(1)NG 标准回流焊温度曲线图(2)OK
PCB镀锡抗蚀不良异常改善报告
抗蚀不良异常改善报告 单位:四川超声印制板有限公司部门:工艺部姓名:白千秋 一、问题描述 2016-11-26,生产编号为S02R4798P的产品在新图电线生产后碱性蚀刻过程中出现焊盘(非孤立焊盘)抗蚀不良异常,产品总数:1块,不良数:1块,不良率100%。 缺陷分布位置:SS面孔焊环 二、临时对策 1.过蚀板件按照品质要求判定报废处理;--AOI扫描检验确定2016-11-26 2.板件补料前优化镀锡电流参数,增加镀锡厚度,增强抗蚀能力:由“1.2ASD×10min” 临时优化为“1.4ASD×10min”--白千秋2016-11-26 对策有效性确认:补板AOI扫描检验数据无过蚀及其他异常,合格率100%;
三、原因分析 1.生产信息查询: ①2016-11-26生产,镀锡电流参数1.2ASD×10min,镀锡缸号:7# ②生产Mapping:查询异常产品前后嫌疑批次,AOI扫描检验数据无过蚀刻异常,故可 以排除镀锡药水及碱性蚀刻线药水的异常。 2.抗蚀不良重现实验&层别对比测试 实验流程: ①投料工艺试板(以S02R4798P资料为模板)3块生产至图形电镀前暂停; ②指定新图电线生产,以0.8ASD×10min、1.2ASD×10min、1.4ASD×10min三种镀锡参数分别生产(1块/挂,共3挂); ③9点发测量抗蚀不良位置(SS面)锡厚; ④碱性蚀刻后送至AOI扫描,确认并记录扫描和检验数据。 实验结果如下表:(层别对比镀锡参数、锡厚、锡缸号的关系) 2板件存在过蚀刻异常; 号板件锡厚比理论锡厚小2.97um,3号板件 7#锡缸)生产。
小结:初步怀疑7#锡缸整流器实际输出电流比设置值偏小,导致SS焊锡面孔环抗蚀不良。对7#锡缸电流进一步测量确认如下: 小结:7#镀锡缸B面(SS焊锡面)整流器实际输出电流确实比显示值偏小,导致S02R4798P 板件镀锡厚度不足(<3um)造成抗蚀不良异常。 3. 5why分析(找出根本原因) Why1:为什么S02R4798P产品焊锡面抗蚀不良? Anser1:焊锡面镀锡厚度不足(<3um),导致抗蚀不良; Why2:为什么焊锡面镀锡厚度不足? Anser2:因为生产中7#镀锡缸B面整流器实际输出电流比显示值小,误差比约为-9.03% Why3:为什么整流器实际输出电流比显示值小而未被发现或重视? Anser3: ①8、9、10月份因测试日期新电镀线正好生产平板电镀,故未对新线锡缸进行测试监控。②判异标准不合适:镀锡整流器电流误差比标准(±10%)不能满足目前镀锡产品锡厚要求。 四、长期改善措施 1.更换新电镀线7#锡缸B面整流器;--- 汪成虎2016-11-30 已完成 2.优化电流实测记录表,增加项目:测试人、判异标准、维修记录、确认人; --- 汪成虎/白千秋2016-12-1 已完成3.镀锡缸整流器电流误差比标准(±10%)变更为-5/+10%(测试记录表修改) --- 汪成虎/白千秋2016-12-1 已完成 五、预防措施(举一反三) 1.全面测量图形电镀线镀锡缸整流器的实际输出电流与显示值的误差比,判定其是否符合新的标准规范,若存在异常,则及时维修或更换。--- 汪成虎/李正2016-12-1 已完成
化金板上锡不良改善报告(2011-12-23)
技术报告 文件编号: 收件 生产、品管、客服、副总办 制作 2011/12/23 抄送 王主管、叶经理、杨经理、席经理、刘副总 审核 FAX 批准 事件 主题: 化金板上锡不良跟进改善报告 责任对象 加工 现状 描述 从9月份开始客户端抱怨化金板上锡不良频繁,9-11三个月均有上锡不良投诉5-6起,现我部根据客户端提供实物板进行相应的测试分析,结合深昊的改善意见,提出了一系列改善措施并要求生产严格执行, 待跟进改善后化金板在客户端上线品质状况,从12月份客户投诉状况来看,上锡不良已有明显改善。 不良 案例 1、 上锡不良案例 1.1、8-12月份上锡不良统计 月份 8月 9月 10月 11月 12月(截止12月23日) 上锡不良(件) 1 6 5 5 1 9-11月上锡不良投诉明显增多 8-12月共投诉18件上锡不良分布图 1.2、客户投诉上锡不良典型案例如下 1.2.1不熔金、缩锡发黑案例 料号 不良描述 不良率 不良周期 相关图片 4513 BGA 处不上锡,且有轻微 的发黑 2% 3111 18901 PAD 吃锡不良,表现为部 分不熔金 6% 3711 4532 整PCS 不吃锡,金完全未 熔,轻拨零件就会脱落 2.5% 4111 上 24688月 9月 10月11月 12月 月 件数不 不65% 缩35% BGA 处不上锡且有发黑 明显有不熔金 整板不熔金且掉件
不良案例1.2.2案例分析 料号BGA处EDS图片EDS光谱图给客户端结论 4513 外界污染 18901 金面轻微污染 4532 金层有阻焊层,可 能有菌类污染 1.2.3小结 从上述三个案例分析来看,不熔金、缩锡发黑应为焊接过程中润湿性不够,导致无法熔掉金层或无法形成IMC层,继而产生上锡不良;影响润湿性原因很多,PCB表面污染、镍层腐蚀氧化等都会影响影响润湿效果,客户端炉温低、锡膏助焊剂差等也会影响润湿性。 上锡不良模拟分析2、原因分析(鱼骨图) 上 锡 不 良锡膏退洗 作业不规范 辅助工具不良 培训不到位 PCB不良 参数不当 保养不到位 酸碱恶劣环境 人 物 环 机 法 锡膏异常客户炉温异常
上锡不良原因
深圳市联益电子有限公司 上锡不良类型及原因分析 一、焊后PCB板面残留多板子脏: 1.FLUX固含量高,不挥发物太多。 2.焊接前未预热或预热温度过低(浸焊时,时间太短)。 3.走板速度太快(FLUX未能充分挥发)。 4.锡炉温度不够。 5.锡炉中杂质太多或锡的度数低。 6.加了防氧化剂或防氧化油造成的。 7.助焊剂涂布太多。 8.PCB上扦座或开放性元件太多,没有上预热。 9.元件脚和板孔不成比例(孔太大)使助焊剂上升。 10.PCB本身有预涂松香。 11.在搪锡工艺中,FLUX润湿性过强。 12.PCB工艺问题,过孔太少,造成FLUX挥发不畅。 13.手浸时PCB入锡液角度不对。 14.FLUX使用过程中,较长时间未添加稀释剂。 二、着火: 1.助焊剂闪点太低未加阻燃剂。 2.没有风刀,造成助焊剂涂布量过多,预热时滴到加热管上。 3.风刀的角度不对(使助焊剂在PCB上涂布不均匀)。 4.PCB上胶条太多,把胶条引燃了。 5.PCB上助焊剂太多,往下滴到加热管上。 6.走板速度太快(FLUX未完全挥发,FLUX滴下)或太慢(造成板面热温度 太高)。 7.预热温度太高。 8.工艺问题(PCB板材不好,发热管与PCB距离太近)。 三、腐蚀(元器件发绿,焊点发黑) 1. 铜与FLUX起化学反应,形成绿色的铜的化合物。 2. 铅锡与FLUX起化学反应,形成黑色的铅锡的化合物。 3. 预热不充分(预热温度低,走板速度快)造成FLUX残留多,有害物残留太多)。 4.残留物发生吸水现象,(水溶物电导率未达标) 5.用了需要清洗的FLUX,焊完后未清洗或未及时清洗。 6.FLUX活性太强。 7.电子元器件与FLUX中活性物质反应。 四、连电,漏电(绝缘性不好) 1. FLUX在板上成离子残留;或FLUX残留吸水,吸水导电。 2. PCB设计不合理,布线太近等。 3. PCB阻焊膜质量不好,容易导电。 五、漏焊,虚焊,连焊 1. FLUX活性不够。
不良事件报告及根本原因分析制度
【密级:□公开■内部□秘密】 1目得 鼓励医院工作人员主动报告不良事件与临界差错信息,医院利用报告系统进行研究、分析,获得安全警示信息与改进建议,增强识别、处理安全隐患与预防不良事件发生得能力,从而实现医院安全目标。 2范围
全院各部门、各科室 3职责 3、1工作人员 发生或发现不良事件立即处理,同时报告上一级直接主管,登录医院内网,填写不良事件报告单,上报给相关职能部门。 3、2各科室负责人 3、2、1确保不良事件得到及时正确处理,将事件损害降低到最小。 3、2、2将警训事件上报主管职能科室,督导科室内人员上报各类不良事件与临界差错。 3、2、3积极组织改进工作,及时反馈给职能部门。 3、3医务科、护理部、设备科、总务科、院感科、保卫科、药剂科、输血科等职能部门 接到各科室报来得不良事件与近似错误信息,将警讯事件或SAC=1、2级不良事件上报至分管院长,积极处理降低损害并及时组织调查、分析、讨论,提出整改意见,及时登录医院内网填写处理意见与改进措施,并适时进行追踪检查评价,对本部门分管得警训事件与严重度评估分级(SAC)1级、2级得不良事件及时组织根本原因分析(RCA),形成分析报告,呈报分管院长、每季度将不良事件得趋势分析与处理情况形成报表,报至质管办。 3、4质管办 接收全院不良事件,对跨部门得警训事件与严重度评估分级(SAC)1级、2级得不良事件及时组织讨论分析,提出改进意见,反馈至相关职能部门,并督促改进。每季度整合各部门不良事件报表,对全院不良事件做整理、分析,每季度或半年汇报至医院质量与安全管理委员会。 3、4院领导:分管院长在接到事件报告后及时呈报院长;院长指派分管副院长,在明确事件性 质得48小时内,启动RCA。 4 定义 4、1不良事件 指在医疗机构中发生得、任何预料之外得,不期望得可能影响患者诊疗结果,增加患者得痛苦与负担得事件,以及影响医院工作得正常运转与医务人员人身安全得因素与事件。按不良事件严重程度分为四类: 4、1、1警讯事件 涉及死亡或严重身体伤害或心理伤害得意外事件。严重身体伤害具体包括丧失四肢或功能。 主要包括以下内容: 4、1、1、1 意外死亡,包括但不限于:与患者病情得自然发展或基本状况无关得死亡(如: 因术后感染或医院获得性肺栓塞而死亡)、足月婴儿得死亡、自杀等; 4、1、1、2与患者病情得自然发展过程或基本状况无关得主要功能永久丧失; 4、1、1、3 手术部位错误、操作错误与患者错误; 4、1、1、4 因输注血液或血液制品,亦或移植受污染得器官或组织二造成感染慢性疾病
上锡不良类型及原因分析
上锡不良类型及原因分析 一、焊后PCB板面残留多板子脏: 1.FLUX固含量高,不挥发物太多。 2.焊接前未预热或预热温度过低(浸焊时,时间太短)。 3.走板速度太快(FLUX 未能充分挥发)。 4.锡炉温度不够。 5.锡炉中杂质太多或锡的度数低。 6.加了防氧化剂或防氧化油造成的。 7.助焊剂涂布太多。 8.PCB上扦座或开放性元件太多,没有上预热。 9.元件脚和板孔不成比例(孔太大)使助焊剂上升。 10.PCB本身有预涂松香。 11.在搪锡工艺中,FLUX润湿性过强。 12.PCB工艺问题,过孔太少,造成FLUX挥发不畅。 13.手浸时PCB入锡液角度不对。 14.FLUX使用过程中,较长时间未添加稀释剂。二、着火: 1.助焊剂闪点太低未加阻燃剂。 2.没有风刀,造成助焊剂涂布量过多,预热时滴到加热管上。 3.风刀的角度不对(使助焊剂在PCB上涂布不均匀)。 4.PCB上胶条太多,把胶条引燃了。 5.PCB 上助焊剂太多,往下滴到加热管上。 6.走板速度太快(FLUX未完全挥发,FLUX滴下)或太慢(造成板面热温度太高)。 7.预热温度太高。 8.工艺问题(PCB板材不好,发热管与PCB距离太近)。三、腐蚀(元器件发绿,焊点发黑) 1. 铜与FLUX起化学反应,形成绿色的铜的化合物。 2. 铅锡与FLUX起化学反应,形成黑色的铅锡的化合物。 3. 预热不充分(预热温度低,走板速度快)造成FLUX残留多,有害物残留太多)。 4.残留物发生吸水现象,(水溶物电导率未达标) 5.用了需要清洗的FLUX,焊完后未清洗或未及时清洗。 6.FLUX活性太强。 7.电子元器件与FLUX中活性物质反应。四、连电,漏电(绝缘性不好) 1. FLUX在板上成离子残留;或FLUX残留吸水,吸水导电。 2. PCB设计不合理,布线太近等。 3. PCB阻焊膜质量不好,容易导电。五、漏焊,虚焊,连焊 1. FLUX活性不够。 2. FLUX的润湿性不够。 wk_ad_begin({pid : 21});wk_ad_after(21, function(){$('.ad-hidden').hide();},
沉锡焊盘上锡不良是什么因素导致沉锡焊盘上锡失效分析详解
沉锡焊盘上锡不良是什么因素导致?沉锡焊盘上锡失效分 析 1. 案例背景 送检样品为某PCBA板,该PCB板经过SMT后,发现少量焊盘出现上锡不良现象,样品的失效率大概在千分之三左右。该PCB板焊盘表面处理工艺为化学沉锡,该PCB板为双面贴片,出现上锡不良的焊盘均位于第二贴片面,失效分析。 2. 分析方法简述 2.1 样品外观观察 如图1所示,通过对失效焊盘进行显微放大观察,焊盘存在不上锡现象,焊盘表面未发现明显变色等异常情况。 图1、失效焊盘图片
2.2 焊盘表面SEM+EDS分析 如图2~4所示,对NG焊盘、过炉一次焊盘、未过炉焊盘分别进行表面SEM观察和EDS 成分分析,未过炉焊盘表面沉锡层成型良好,过炉一次焊盘和失效焊盘表面沉锡层出现重结晶,表面均未发现异常元素; 图2. NG焊盘的SEM照片及EDS能谱
图3.过炉一次焊盘的SEM照片+EDS能谱图
图4.未过炉焊盘的SEM照片+EDS能谱图 2.3 焊盘FIB制样剖面分析 如图5~7所示,利用FIB技术对失效焊盘、过炉一次焊盘及未过炉焊盘制作剖面,对剖面表层进行成分线扫描,发现NG焊盘表层已经出现Cu元素,说明Cu已经扩散至锡层表面;过炉一次焊盘表层在0.3μm左右深度出现Cu元素,说明过炉一次焊盘后,纯锡层厚度约为0.3μm;未过炉焊盘的表层在0.8μm左右深度出现Cu元素,说明未过炉焊盘的纯锡层厚度约为0.8μm。鉴于EDS测试精度较低,误差相对较大,接下来采用AES对焊盘表面成分进行进一步分析。
图5. NG焊盘剖面的SEM照片及EDS能谱
图6.过炉一次焊盘剖面的SEM照片+EDS能谱图
SMT上锡不良的解决办法
SMT上锡不良的解决办法 波峰面:波的表面均被一层氧化皮覆盖﹐它在沿焊料波的整个长度方向上几乎都保持静态﹐在波峰焊接过程中﹐PCB接触到锡波的前沿表面﹐氧化皮破裂﹐PCB前面的锡波无皲褶地被推向前进﹐这说明整个氧化皮与PCB以同样的速度移动波峰焊机。 焊点成型:当PCB进入波峰面前端(A)时﹐基板与引脚被加热﹐并在未离开波峰面(B)之前﹐整个PCB浸在焊料中﹐即被焊料所桥联﹐但在离开波峰尾端的瞬间﹐少量的焊料由于润湿力的作用﹐粘附在焊盘上﹐并由于表面张力的原因﹐会出现以引线为中心收缩至最小状态﹐此时焊料与焊盘之间的润湿力大于两焊盘之间的焊料的内聚力。因此会形成饱满﹐圆整的焊点﹐离开波峰尾部的多余焊料﹐由于重力的原因﹐回落到锡锅中。 防止桥联的发生 1、使用可焊性好的元器件/PCB 2、提高助焊剞的活性 3、提高PCB的预热温度﹐增加焊盘的湿润性能 4、提高焊料的温度 5、去除有害杂质﹐减低焊料的内聚力﹐以利于两焊点之间的焊料分开。 波峰焊机中常见的预热方法 1、空气对流加热 2、红外加热器加热 3、热空气和辐射相结合的方法加热 波峰焊工艺曲线解析 1、润湿时间:指焊点与焊料相接触后润湿开始的时间 2、停留时间:PCB上某一个焊点从接触波峰面到离开波峰面的时间,停留/焊接时间的计算方式是﹕停留/焊接时间=波峰宽/速度 3、预热温度:预热温度是指PCB与波峰面接触前达到的温度(见右表) 4、焊接温度 焊接温度是非常重要的焊接参数﹐通常高于焊料熔点(183°C )50°C ~60°C大多数情况是指焊锡炉的温度实际运行时﹐所焊接的PCB 焊点温度要低于炉温﹐这是因为PCB吸热的结果 SMA类型元器件预热温度 单面板组件通孔器件与溷装90~100 双面板组件通孔器件100~110 双面板组件溷装100~110 多层板通孔器件15~125 多层板溷装115~125 波峰焊工艺参数调节 1、波峰高度:波峰高度是指波峰焊接中的PCB吃锡高度。其数值通常控制在PCB板厚度的1/2~2/3,过大会导致熔融的焊料流到PCB 的表面﹐形成“桥连” 2、传送倾角:波峰焊机在安装时除了使机器水平外﹐还应调节传送装置的倾角﹐通过倾角的调节﹐可以调控PCB与波峰面的焊接时间﹐适当的倾角﹐会有助于焊料液与PCB更快的剥离﹐使之返回锡锅内 3、热风刀:所谓热风刀﹐是SMA刚离开焊接波峰后﹐在SMA的下方放置一个窄长的带开口的“腔体”﹐窄长的腔体能吹出热气流﹐
如何对付SMT的上锡不良
如何对付SMT的上锡不良 波峰面:波的表面均被一层氧化皮覆盖﹐它在沿焊料波的整个长度方向上几乎都保持静态﹐在波峰焊接过程中﹐PCB接触到锡波的前沿表面﹐氧化皮破裂﹐PCB前面的锡波无皲褶地被推向前进﹐这说明整个氧化皮与PCB以同样的速度移动波峰焊机。 焊点成型:当PCB进入波峰面前端(A)时﹐基板与引脚被加热﹐并在未离开波峰面(B)之前﹐整个PCB浸在焊料中﹐即被焊料所桥联﹐但在离开波峰尾端的瞬间﹐少量的焊料由于润湿力的作用﹐粘附在焊盘上﹐并由于表面张力的原因﹐会出现以引线为中心收缩至最小状态﹐此时焊料与焊盘之间的润湿力大于两焊盘之间的焊料的内聚力。因此会形成饱满﹐圆整的焊点﹐离开波峰尾部的多余焊料﹐由于重力的原因﹐回落到锡锅中。 防止桥联的发生 1、使用可焊性好的元器件/PCB 2、提高助焊剞的活性 3、提高PCB的预热温度﹐增加焊盘的湿润性能 4、提高焊料的温度 5、去除有害杂质﹐减低焊料的内聚力﹐以利于两焊点之间的焊料分开。 波峰焊机中常见的预热方法 1、空气对流加热 2、红外加热器加热 3、热空气和辐射相结合的方法加热 波峰焊工艺曲线解析 1、润湿时间:指焊点与焊料相接触后润湿开始的时间 2、停留时间:PCB上某一个焊点从接触波峰面到离开波峰面的时间,停留/焊接时间的计算方式是﹕停留/焊接时间=波峰宽/速度 3、预热温度:预热温度是指PCB与波峰面接触前达到的温度(見右表) 4、焊接温度 焊接温度是非常重要的焊接参数﹐通常高于焊料熔点(183°C )50°C ~60°C大多数情况是指焊锡炉的温度实际运行时﹐所焊接的PCB 焊点温度要低于炉温﹐这是因为PCB 吸热的结果 SMA類型元器件預熱溫度 單面板組件通孔器件與混裝90~100 雙面板組件通孔器件100~110 雙面板組件混裝100~110 多層板通孔器件15~125 多層板混裝115~125 波峰焊工艺参数调节 1、波峰高度:波峰高度是指波峰焊接中的PCB吃錫高度。其數值通常控制在PCB板厚度的1/2~2/3,過大會導致熔融的焊料流到PCB的表面﹐形成“橋連”
护理不良事件原因分析报告
2013年第一季度护理不良事件案例成因分析报告 造成护理不良事件的主要原因是由于护理人员在工作中责任心不强、不严格遵守规章制度、查对制度流于形式、违反操作规程、巡视病房不及时、沟通不良、疏于个人防护等而发生的。 护理不良事件的发生直接或间接影响病人病情,造成了护患矛盾产 生,影响了医院的护理安全。 一、护理不良事件来源及后果 2013年第一季度共发生护理不良事件6例,来源于临床科室及门诊科室,虽未给患者造成严重不良后果,但也影响了医院的护理安全。 二、发生不良事件的原因 1、查对制度落实不到位:不认真执行各种查对制度,具体表现用药查对不严,在给病人发药时未能及时发现患者外出,未告知病人用药须知,未能提高患者用药依从性。 2、巡视病房不及时,未能按照级别护理要求巡视病房,个别护士在值班,夜班如无新入院病人,则减少进病房巡视次数,或巡视时走马观
花,未仔细检查病人的生命体征;或认为新入院病人无大碍,未详细了解病人情况及时发现病情变化。 3、护理人员缺乏急救意识,不能及时发现判断并发症的发生。透析病人为门诊治疗,大多数病人病情稳定,生存期长,护理人员对透析中一般不良反应处理比较有经验,对不常规的严重并发症没有预先性,缺乏观察处理经验。 4、个人防护不到位,特别是在为患者进行操作治疗时,违反操作规程,个人防护意识不强,简化流程,存在懒惰心理,工作随意性太强,导致被针刺伤。 5、安全防护措施不到位,未认真向患者及家属告知,对于一些病情不平稳的患者,特别是新入院病人、产后、术后患者未及时进行评估,工作疏忽大意,导致产妇起床解手出现晕厥。 6、护士长监管力度不够,特别是重点环节、重点时段、重点病人 的管理。 三、预防护理不良事件发生的措施 1、护士长认真组织学习核心制度,特别是查对制度,必须做到人人熟练掌握,同时在日常工作中加强重点时段、重点环节、重点病人的管理,只有人人掌握了流程、标准、才可能正确的执行。 2、严格执行分级护理制度,密切观察患者病情变化,按照级别护理巡视病房,对高危患者进行评估,米取安全防护措施,如床栏、约束带等,同时告知家属留陪侍人,必要时悬挂安全警示标识。
SMT锡膏常见不良问题及原因分析—双智利
SMT锡膏常见不良问题及原因分析——双智利 一.锡球: 1.印刷前,锡膏未充分回温解冻并搅拌均匀。 2.印刷后太久未回流,溶剂挥发,膏体变成干粉后掉到油墨上。 3.印刷太厚,元件下压后多余锡膏溢流。 4.REFLOW时升温过快(SLOPE>3),引起爆沸。 5.贴片压力太大,下压使锡膏塌陷到油墨上。 6.环境影响:湿度过大,正常温度25+/-5,湿度40-60%,下雨时可达95%,需要抽湿。 7.焊盘开口外形不好,未做防锡珠处理。 8.锡膏活性不好,干的太快,或有太多颗粒小的锡粉。 9.锡膏在氧化环境中暴露过久,吸收空气中的水分。 10.预热不充分,加热太慢不均匀。 11.印刷偏移,使部分锡膏沾到PCB上。 12.刮刀速度过快,引起塌边不良,回流后导致产生锡球。 P.S:锡球直径要求小于0.13MM,或600平方毫米小于5个. 二、立碑: 1.印刷不均匀或偏移太多,一侧锡厚,拉力大,另一侧锡薄拉力小,致使元件一端被拉向一侧形成空焊,一端被拉起就形成立碑。 2.贴片偏移,引起两侧受力不均。 3.一端电极氧化,或电极尺寸差异太大,上锡性差,引起两端受力不均。 4.两端焊盘宽窄不同,导致亲和力不同。
5.锡膏印刷后放置过久,FLUX挥发过多而活性下降。 6.REFLOW预热不足或不均,元件少的地方温度高,元件多的地方温度低,温度高的地方先熔融,焊锡形成的拉力大于锡膏对元件的粘接力,受力不均匀引起立碑。 三、短路 1.STENCIL太厚、变形严重,或STENCIL开孔有偏差,与PCB焊盘位置不符。 2.钢板未及时清洗。 3.刮刀压力设置不当或刮刀变形。 4.印刷压力过大,使印刷图形模糊。 5.回流183度时间过长,(标准为40-90S),或峰值温度过高。 6.来料不良,如IC引脚共面性不佳。 7.锡膏太稀,包括锡膏内金属或固体含量低,摇溶性低,锡膏容易榨开。 8.锡膏颗粒太大,助焊剂表面张力太小。 四、偏移: 一).在REFLOW之前已经偏移: 1.贴片精度不精确。 2.锡膏粘接性不够。 3.PCB在进炉口有震动。 二).REFLOW过程中偏移: 1.PROFILE升温曲线和预热时间是否适当。 2.PCB在炉内有无震动。
不良原因分析
不良原因分析模具型式:復合下料模 毛邊太高 1、研磨刃口; 2、導柱磨損換新; 3、公母模間隙修正; 4、刀口處理﹔ 5、模板變形,重修重合。 未能脫料 1、脫料板鑽頂料銷﹔ 2、材料表面太油,擦試﹔ 3、模板刮傷,材料附著,磨平﹔ 4、毛邊太高附眷,修刃口。 沖頭斷裂 1、換沖頭﹔ 2、檢查脫料板活動性﹔ 3、下模孔是否退料不良﹔ 4、模孔間隙過小得加大﹔ 5、沖子處理不良,回火﹔ 6、夾板偏斜,孔重修正﹔ 7、逃孔不良,磨大磨順。 刀口鈍、裂 1、模板處理不良,再淬火或回火﹔ 2、刀口氬焊后修正﹔ 3、間隙過小應磨成正確尺寸﹔ 4、彈簧壓力太大,應均勻調整﹔ 5、模板材質不良,重換﹔ 6、模板變形,磨平,修正 脫料板附著 1、彈簧追加﹔ 2、板邊附著料屑,清洗干淨﹔ 3、鎖附螺絲孔位偏,加大﹔ 4、沖子孔太緊,磨順,活動間隙0.02mm~0.03mm 5、模板邊壓傷,磨平﹔ 6、模板變形,平面磨平,邊緣修正 沖孔偏移
1、內脫料板不准,重修﹔ 2、沖頭長度得超出母模面,否則不准﹔ 3、公母模不准影響,重合公母模﹔ 4、夾板、內脫料偏斜過大,修正夾板﹔ 廢料附著 1、退磁﹔ 2、下模孔過大,割入子入入塊﹔ 3、下模退廢料孔不順,磨順﹔ 4、沖料表面油質太粘,擦淨 模具型式:成型模 尺寸不准 1、案內重新調整; 2、模板尺寸不准,重修整﹔ 3、公母模重處理,重磨﹔ 4、下料展開錯誤,重修﹔ 5、材質不良,修整模板尺寸﹔ 6、沖制深淺調整。 不能直角 1、模具公母模間隙重調整﹔ 2、沖制素材材質不同,母模刀口R小﹔ 3、公模邊磨壓線(如:右圖,尺寸選取視料厚) ﹔ 4、公模刀口面外,磨斜度逃料﹔ 5、兩次成型﹔ 6、強化脫料板﹔ 7、軟化脫料板﹔ 8、模板平面不正,重架模 不能退料 1、追加頂料銷﹔ 2、公模刀口太尖銳,以磨石梢磨﹔ 3、刀口變形,再處理,磨整﹔ 4、公母模間隙不足,沖材擠壓,修正尺寸﹔ 5、上下模成形后,平面傾斜,重架模及磨平模板。退料變形 1、頂料不均,重新調整﹔ 2、彈簧彈力失調,重換﹔ 3、消除公母模變形度﹔
化金板上锡不良改善报告
技术报告
不良案例1、上锡不良案例 1.1、8-12月份上锡不良统计 月份8月9月10月11月12月(截止12月23日)上锡不良(件) 1 6 5 5 1 9-11月上锡不良投诉明显增多8-12月共投诉18件上锡不良分布图1.2、客户投诉上锡不良典型案例如下 1.2.1不熔金、缩锡发黑案例 料号不良描述不良率不良周期相关图片 4513 BGA处不上锡,且有轻 微的发黑 2% 3111 18901 PAD吃锡不良,表现为 部分不熔金 6% 3711 4532 整PCS不吃锡,金完全 未熔,轻拨零件就会脱落 2.5% 4111 上锡不良 2 4 6 8 8月9月10月11月12月 月份 件 数 不良分布 不熔金 65% 缩锡发黑 35% BGA处不 上锡且有 明显有不 整板不熔
不良案例1.2.2案例分析 料号BGA 处EDS图片EDS光谱图给客户端结论 4513 外界污染 18901 金面轻微污染 4532 金层有阻焊层,可 能有菌类污染 1.2.3小结 从上述三个案例分析来看,不熔金、缩锡发黑应为焊接过程中润湿性不够,导致无法熔掉金层或无法形成IMC层,继而产生上锡不良;影响润湿性原因很多,PCB表面污染、镍层腐蚀氧化等都会影响影响润湿效果,客户端炉温低、锡膏助焊剂差等也会影响润湿性。 上锡不良模拟分析2、原因分析(鱼骨图) 上 锡 不 良锡膏退洗 作业不规范 辅助工具不良 培训不到位 PCB不良 参数不当 保养不到位 酸碱恶劣环境 人 物 环 机 法 锡膏异常客户炉温异常
调查跟踪4.不良问题跟踪 4.1.上文提到的3.1.1及3.1.2在之前的上锡不良改善方案中早有要求,各部门必须严格按章操作。 4.2化金线保养不到位,并不是化金未做保养,而是在酸碱泡或换槽时未用扫把或碎布彻底清洗槽壁污垢, 还有部分水洗未按要求更换,可能让缸壁滋生菌类有“可趁之机”。 4.2.1.前处理酸洗槽大保养后及用扫把及碎布彻底清洁后对比 4-1酸碱泡后缸壁仍有污垢4-2用扫把彻底清洁后 4.2.2.金回收后水洗槽缸壁大保养后及用扫把及碎布彻底清洁后对比 明显有污垢污垢已被 白色污垢 用扫把清洗多次才能 清洗干净,此污垢可
SMT焊接上锡不良分析
SMT焊接上锡不良分析 编辑:时运电子 波峰面:波的表面均被一層氧化皮覆蓋﹐它在沿焊料波的整個長度方向上幾乎都保持靜態﹐在波峰焊接過程中﹐PCB接觸到錫波的前沿表面﹐氧化皮破裂﹐PCB前面的錫波無皸褶地被推向前進﹐這說明整個氧化皮與PCB以同樣的速度移動波峰焊機。 焊點成型:當PCB進入波峰面前端(A)時﹐基板與引腳被加熱﹐並在未離開波峰面(B)之前﹐整個PCB浸在焊料中﹐即被焊料所橋聯﹐但在離開波峰尾端的瞬間﹐少量的焊料由於潤濕力的作用﹐粘附在焊盤上﹐並由於表面張力的原因﹐會出現以引線為中心收縮至最小狀態﹐此時焊料與焊盤之間的潤濕力大於兩焊盤之間的焊料的內聚力。因此會形成飽滿﹐圓整的焊點﹐離開波峰尾部的多餘焊料﹐由於重力的原因﹐回落到錫鍋中。 防止橋聯的發生: 1、使用可焊性好的元器件/PCB 2、提高助焊剞的活性 3、提高PCB的預熱溫度﹐增加焊盤的濕潤性能 4、提高焊料的溫度 5、去除有害雜質﹐減低焊料的內聚力﹐以利於兩焊點之間的焊料分開。 波峰焊機中常見的預熱方法 1、空氣對流加熱 2、紅外加熱器加熱 3、熱空氣和輻射相結合的方法加熱 波峰焊工藝曲線解析 1、潤濕時間:指焊點與焊料相接觸後潤濕開始的時間 2、停留時間CB上某一個焊點從接觸波峰面到離開波峰面的時間,停留/焊接時間的計算方式 是﹕停留/焊接時間=波峰寬/速度 3、預熱溫度:預熱溫度是指PCB與波峰面接觸前達到的溫度(見右表) 4、焊接溫度: 焊接溫度是非常重要的焊接參數﹐通常高於焊料熔點(183°C )50°C ~60°C 大多數情況是指焊錫爐的溫度實際運行時﹐所焊接的PCB 焊點溫度要低於爐溫﹐這是因為PCB吸熱的結果 SMA類型元器件預熱溫度 單面板組件通孔器件與混裝90~100 雙面板組件通孔器件100~110 雙面板組件混裝100~110 多層板通孔器件15~125
锂电池生产中各种不良原因及分析报告
各种不良原因的造成以及原因分析20130830 一、短路: 1、隔膜刺穿: 1)极片边尾有毛刺,卷绕后刺穿隔膜短路(分切刀口有毛刺、装配有误); 2)极耳铆接孔不平刺穿隔膜(铆接机模具不平); 3)极耳包胶时未包住极耳铆接孔和极片头部(裁大片时裁刀口有毛刺); 4)卷绕时卷针划破隔膜(卷针两侧有毛刺); 5)圧芯时气压压力太大、太快压破隔膜(气压压力太大,极片边角有锐角刺穿隔膜纸)。 2、全盖帽时极耳靠在壳闭上短路: 1)高温极耳胶未包好; 2)壳壁胶纸未贴到位; 3)极耳过长弯曲时接触盖帽或壳壁。 3、化成时过充短路: 1)化成时,正负极不明确反充而短路; 2)过压时短路; 3)上柜时未装好或部电液少,充电时温度过高而短路。 4、人为将正负极短路: 1)分容上柜时正负极直接接触; 2)清洗时短路。 二、高阻: 1、焊接不好:极耳与极片的焊接;极耳与盖有虚焊。 2、电液偏少:注液量不准确偏少;封口时挤压力度过大,挤出电液。 3、装配结构不良:极片之间接触不紧密;各接触点面积太小。 4、材质问题:极耳及外壳的导电性能;电液的导电率;石墨与碳粉的导电率。 三、发鼓: 1、电池有水分:制造流程时间长;空气潮湿;极片未烘干;填充量过大,入壳后直接发鼓;极片反弹超厚,入壳后发鼓。 2、短路:过充或短路。 3、高温时发鼓;超过50°C温度发鼓。 四、低容量:
1、敷料不均匀,偏轻或配比不合理。 2、生产时断片、掉料。 3、电液量少。 4、压片过薄。 五、极片掉料: 1、烘烤温度过高,粘接剂失效。 2、拉浆温度过高。 3、各种材料因素:如P01、PVDF、SBR、CMC等性能问题。 4、敷料不均匀。 六、极片脆: 1、面密度大,压片太薄。 2、烘烤温度过高。 3、材料的颗粒度,振头密度等。 各工位段不良原因的造成及违规操作 一、配料: 不良原因:1)各种添加剂与P01的配比; 2)浆料中的气泡;导致拉浆时不良率增加,以及 3)浆料中的颗粒;正负极活性物质的容量发挥和 4)浆料的粘度。极片掉料。 不良操作:1)加入添加剂时少加或多加; 2)浆料搅拌时间不准确; 3)浆料中添加剂或多或少。 二、拉浆: 不良原因:1)敷料不均; 2)掉料或湿片;不良率增多,和电池性能不好。 3)断带。 不良操作:1)刀口调试不标准或刀口垫干料,或走速太快;
连接器引脚上锡不良失效分析
连接器引脚上锡不良失效分析 (作者:美信检测失效分析实验室) 1. 案例背景 送检样品为某款PCBA板,该PCBA板上一连接器在经过SMT后发现个别引脚上锡不良,失效不稳定;该连接器引脚每侧共50个引脚,材质为铜表面镀镍镀锡,PCB焊盘表面为OSP 工艺,锡膏成分为Sn-Ag-Cu(95%-3%-0.5%)。 2. 分析方法简述 2.1 样品外观观察 通过将失效样品和正常样品分别放在体式显微镜下观察,发现失效样品的某些引脚确实存在引脚上锡不良现象,失效引脚位置在连接器上分布不规律,但失效样品主要集中在连接器中间区域,且两端引脚上锡相对较好,典型照片见图1。正常样品表现为两端上锡饱满,中间区域引脚上锡不饱满,典型照片见图2,该现象说明失效可能与位置相关。
上锡不饱满 上锡不良 上锡饱满 上锡饱满 上锡不饱满 上锡饱满
如图3~4所示,分别对NG焊点表面和未使用引脚表面进行表面SEM观察和EDS成分分析,成分测试结果见表1~2,均未发现明显污染元素,说明造成该引脚上锡不良与污染相关性不大。 表2 未使用连接器引脚表面EDS测试结果(Wt%)
将NG焊点分别按照横向和纵向制作切片,观察焊点内部连接情况: 如图5和表3所示,通过纵向切片可知,焊锡与焊盘间形成良好IMC层,而引脚与焊锡之间出现分离,分层中间存在异物,通过对异物进行成分分析,主要元素为C、O、Sn、Br,怀疑其可能为助焊剂; 如图6和表4所示,通过横向切片可知,NG焊点引脚与焊盘存在偏位现象,表现为两侧不上锡,焊锡与焊盘形成均匀连续的IMC层,引脚底部与焊锡之间亦存在分层,中间也存在异物。通过对分层处进行放大观察,发现引脚底部存在一层锡层,锡层成分为纯锡(如图6中位置1和2所示);而焊点焊锡成分中含少量Ag(位置4和5),与锡膏(Sn-Ag-Cu:95%-3%-0.5%)中成分相对应。由此可推出,NG焊点引脚底部锡层为引脚表面镀锡层,因此可侧面说明NG焊点在SMT过炉过程中,引脚底部与焊锡没有良好接触。
PCBA透锡不良分析
PCBA透锡不良分析 一、PCBA透锡要求 根据IPC标准,通孔焊点的PCBA透锡要求一般在75%以上就可以了,也就是说焊接的对面板面外观检验透锡标准是不低于孔径高度(板厚)的75%,PCBA透锡在75%-100%都是合适。而镀通孔连接到散热层或起散热作用的导热层,PCBA透锡则要求50%以上。 二、影响PCBA透锡的因素 PCBA透锡不良主要受材料、波峰焊工艺、助焊剂、手工焊接等因素的影响。 关于影响PCBA透锡的因素的具体分析: 1、材料 高温融化的锡具有很强的渗透性,但并不是所有的被焊接金属(PCB板、元器件)都能渗透进去,比如铝金属,其表面一般都会自动形成致密的保护层,而且内部的分子结构的不同也使得其他分子很难渗透进入。其二,如果被焊金属表面有氧化层,也会阻止分子的渗透,我们一般用助焊剂处理,或纱布刷干净。
2、波峰焊工艺 PCBA透锡不良自然直接与波峰焊接的工艺有着直接的关系,重新优化透锡不好的焊接参数,如波高、温度、焊接时间或移动速度等。首先,轨道角度适当的降一点,并增加波峰的高度,提高液态锡与焊端的接触量;然后,增加波峰焊接的温度,一般来说,温度越高锡的渗透性越强,但这要考虑元器件的可承受温度;最后,可以降低传送带的速度,增加预热、焊接时间,使助焊剂能充分去除氧化物,浸润焊端,提高吃锡量。 3、助焊剂 助焊剂也是影响PCBA透锡不良的重要因素,助焊剂主要起到去除PCB和元器件的表面氧化物以及焊接过程防止再氧 化的作用,助焊剂选型不好、涂敷不均匀、量过少都将导致透锡不良。可选用知名品牌的助焊剂,活化性和浸润效果会更高,可有效的清除难以清除的氧化物;检查助焊剂喷头,损坏的喷头需及时更换,确保PCB板表面涂敷适量的助焊剂,发挥助焊剂的助焊效果。 4、手工焊接 在实际插件焊接质量检验中,有相当一部分焊件仅表面焊锡形成锥形后,而过孔内没有锡透入,功能测试中确认这部分有许多是虚焊,这种情况多出在手工插件焊接中,原因是烙
焊接不良的原因分析
焊接不良的原因分析 吃锡不良 其现象为线路的表面有部份未沾到锡,原因为: 1.表面附有油脂、杂质等,可以溶剂洗净。 2.基板制造过程时打磨粒子遗留在线路表面,此为印刷电路板制造厂家的问题。 3.硅油,一般脱模剂及润滑油中含有此种油类,很不容易被完全清洗干净。所以在电子零件的制造过程中,应尽量避免化学品含有硅油者。焊锡炉中所用的氧化防止油也须留意不是此类的油。 4.由于贮存时间、环境或制程不当,基板或零件的锡面氧化及铜面晦暗情形严重。换用助焊剂通常无法解决此问题,重焊一次将有助于吃锡效果。 5.助焊剂使用条件调整不当,如发泡所需的空气压力及高度等。比重亦是很重要的因素之一,因为线路表面助焊剂分布数量的多寡受比重所影响。检查比重亦可排除因卷标贴错,贮存条件不良等原因而致误用不当助焊剂的可能性。 6.焊锡时间或温度不够。一般焊锡的操作温度较其溶点温度高55~80℃ 7.不适合之零件端子材料。检查零件,使得端子清洁,浸沾良好。 8.预热温度不够。可调整预热温度,使基板零件侧表面温度达到要求之温度约90℃~110℃。 9.焊锡中杂质成份太多,不符合要求。可按时测量焊锡中之杂质,若不合规定超过标准,则更换合于标准之焊锡。 退锡 多发生于镀锡铅基板,与吃锡不良的情形相似;但在欲焊接的锡路表面与锡波脱离时,大部份已沾在其上的焊锡又被拉回到锡炉中,所以情况较吃锡不良严重,重焊一次不一定能改善。原因是基板制造工厂在渡锡铅前未将表面清洗干净。此时可将不良之基板送回工厂重新处理。 冷焊或点不光滑 此情况可被列为焊点不均匀的一种,发生于基板脱离锡波正在凝固时,零件受外力影响移动而形成的焊点。 保持基板在焊锡过后的传送动作平稳,例如加强零件的固定,注意零件线脚方向等;总之,待焊过的基板得到足够的冷却再移动,可避免此一问题的发生。解决的办法为再过一次锡波。至于冷焊,锡温太高或太低都有可能造成此情形。
塑胶产品不良原因分析报告
塑料制品不良原因之判定及处理方法 1.缩水 2.成品黏模(脱模困难) 3.浇道黏模 4.成品内有气孔 5.成品变形 6.银纹、气疮 7.毛边、彼锋 8.成品短射 9.结合线 10.成品表面光泽不良 11.黑纹 12.流纹 13.开模时或顶出时成品破裂 塑料成形产品,原则上都是依据标准规格要求制造.但无论如何它的变化仍是相当广泛的.有时当生产很顺利进行时会突然产生缩水变形,有裂痕、银纹,或其它缺陷等无法接受的产品.在生产时就要从成品发生的问题,来了解判断问题点所在,这是一种专门性技术及经验的累积.如果我们把成品上的缺失,涵盖在四个主要因素当中,那就是原料,模具、成型机及成形条件(如表一所列四项).有时变更操作条件,或模具、机器方面稍做调整,以及过滤所使用的原料,就可以解决问题所在.本章就逐一列举成品可能发生的问题,并加以探讨解决之道. 射出成型条件对成型品物性的影响, 大致可从四方面来考虑:1.原料 2.成形机 3.模具设计 4.成型条件
刚性 强韧性 性 温度( 可 射出速度 4-1 缩水 塑料品在表面的凹陷、空洞都称为「缩水」,除了会影响产品外 观亦会降低成品质量及强度.缩水的原因与成型技术、模具设计及使用塑料均有关系. 塑料: 不同塑料原料的缩水率,表一参考数据.通常易缩水的原料都属于结晶性的,如尼龙、百折胶等等.在射出过程中,结晶性塑料受热成流体状态,分子呈无规则排列;当射入较冷的模腔时,塑料分子便慢慢整齐排列形成结晶,结果体积缩小小于规定尺寸范围,就是所谓的“缩水”.
射出技术: 在射出技术控制方面,出现缩水的情况有:压力不足、射出速度太慢、烧口太小成浇道太长等等.所以在使用射出机时,必须注意成形条件及保压是否足够,以防造成缩水问题. 模具及产品设计方面: 模具的流道设计及冷却装置、对成品之影响亦很大出于塑料之传热能力较低,故距离模壁越远越厚、则其凝固及冷却较慢,应有足够的塑料填满模腔,使射出机的螺杆在射出或保压时,塑料不会倒流而减低压力,另一方面水面亦不能冷却太快,以免半固塑料阻塞流道造成压力下降,引致成品缩水.不同的模流过程有不同的收缩率,熔融筒的温度控制得宜,可防止塑件过热;延长周期,可确保制品有充分时间冷却. 缩水问题如获适当解决,可提高成品质量,减低次废产品并提高生产效率.下表即为缩水可能发生之原因及处理方法.
- 失效分析案例--PCB上锡不良缺陷分析
- 无铅HASL上锡不良案例分析
- 化金板上锡不良改善报告(2011-12-23)
- PCB拒焊不良分析报告---上海
- 失效分析案例CB上锡不良缺陷分析
- 失效分析案例CB上锡不良缺陷分析
- 无铅喷锡SMT上锡不良的几种分析思路
- “4619”半孔焊接爬锡上锡不良分析报告概述
- 1540321981-连接器连锡不良原因分析及改善报告2015-6-7
- SMT焊接上锡不良分析
- 不良分析报告
- SMT不良分析报告
- 上锡不良分析改善报告
- BGA不良分析、改善报告
- 波峰焊吃锡不良分析及对策
- 三大不良分析报告
- 制程不良原因分析报告
- 沉镍金板上锡不良分析报告
- 不良分析报告
- 10月制程不良分析总结报告
